CMOS射频电路中MOSFET短沟道效应及热载流子影响
CMOS射频电路中MOSFET短沟道效应及热载流子影响
随着CMOS技术不断发展,MOSFET的通道长度不断缩小,芯片上被动器件如电感器的性能也不断提升。这使得CMOS技术成为了实现射频(RF)电路模块,如低噪声放大器(LNA)、振荡器和混频器等的可行选择[1-8]。
然而,MOSFET通道长度的缩短也带来了一些挑战,其中最主要的挑战是短沟道效应,例如漏极诱导势垒降低(DIBL)[9]、穿透和热载流子效应。
热载流子的产生
在NMOSFET中,当器件工作在饱和区时,靠近漏极的通道部分(称为截止区)的电场强度会显著高于通道的其他区域[11]。进入该区域的载流子会获得高能量,因此被称为热载流子。
雪崩效应
当热载流子流向漏极时,它们会与硅原子发生碰撞,并产生新的电子-空穴对,这一过程被称为雪崩效应,类似于反向偏置PN结的击穿现象。
热载流子的影响
在雪崩过程中产生的新电子和空穴分别被漏极和衬底端口带走,流经衬底端口的电流被称为Isub。热载流子还会撞击硅和二氧化硅之间的原子键,对器件的长期可靠性产生负面影响。
总而言之,MOSFET的短沟道效应,特别是热载流子效应,对CMOS射频电路的性能和可靠性有 significant 影响。为了实现高性能、高可靠性的CMOS射频电路,需要对这些效应进行深入研究,并采取相应的措施来抑制或减轻它们的影响。
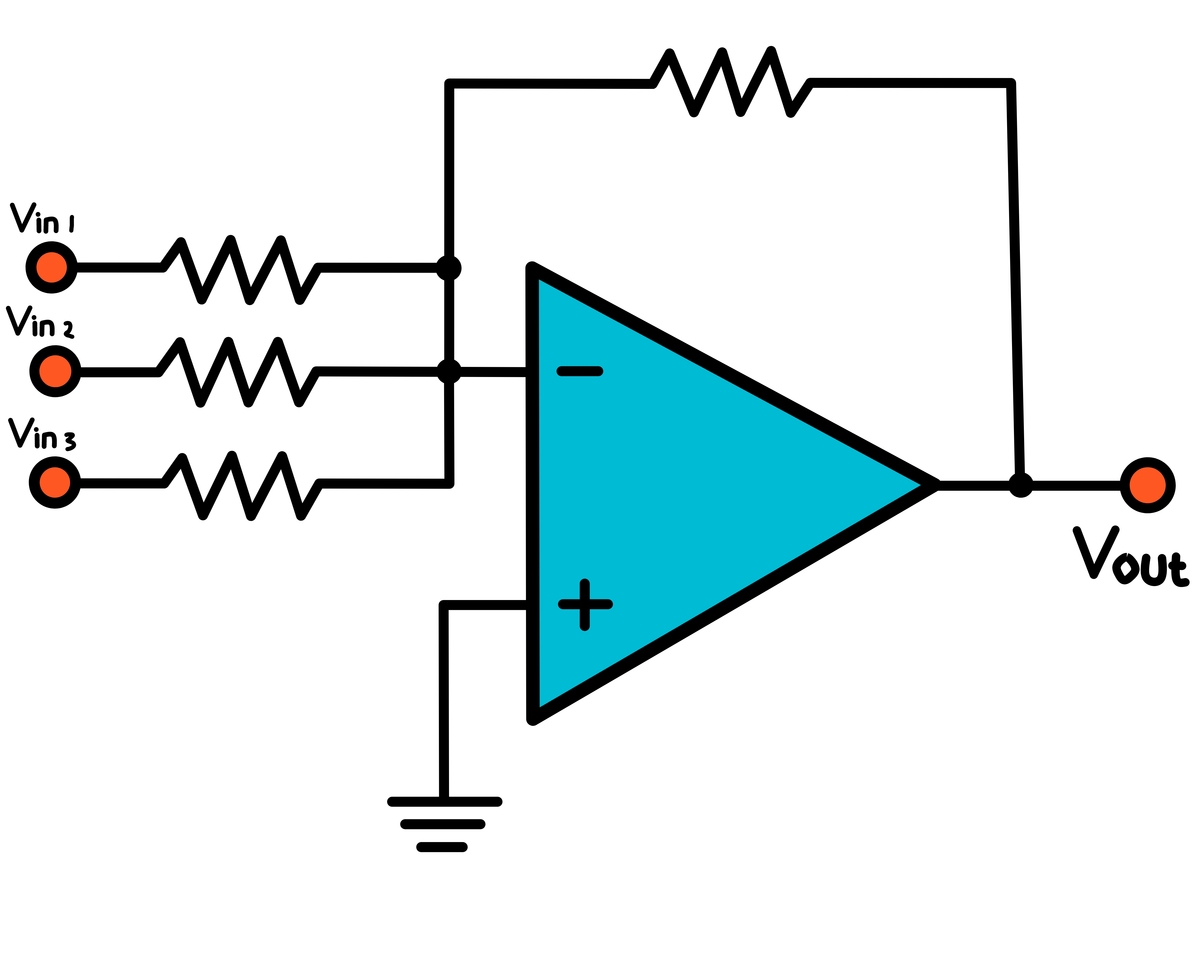
原文地址: https://www.cveoy.top/t/topic/jnyu 著作权归作者所有。请勿转载和采集!